BGA组装工艺在贴片加工中具有哪些特点呢?
BGA(即球栅阵列)具有多种结构,包括塑封BGA (P-BGA)、倒装BGA(F-BGA)、载带BGA(T-BGA)和陶瓷BGA(C-BGA)。这些结构的详细信息请参阅本书1.4节。BGA的工艺特点如下:
1) BGA的引脚(焊球)位于封装体底部,无法被肉眼直接观察到焊接情况,需要使用X光设备进行检测。
2) BGA是一种湿敏器件,如果受潮,可能会导致变形加剧或者发生不良现象,例如“爆米花”。因此,在贴片之前,必须确认其是否符合工艺标准。
3) BGA也是一种应力敏感的元件,其四角焊点容易受到应力集中的影响,在机械应力的作用下可能会容易折断。因此,在PCB设计时应尽量将其安放在离拼板边和安装螺丝区域较远的地方。
总的来说,BGA焊接的工艺特性非常好,但也存在一些与BGA封装结构有关的特殊焊接问题。尤其是在薄型FCBGA和PBGA封装中,由于封装的多层结构,在焊接过程中会发生变形现象。通常将这种在焊接过程中发生的变形称为动态变形,它是导致BGA组装不良的主要原因之一。
FC-BGA加热过程中出现动态变形的原因在于BGA具有层状结构,各层材料的线膨胀系数(CTE)存在较大差异,详见图4-34。
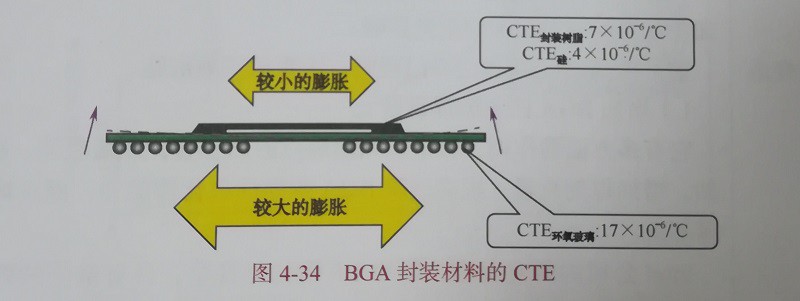
BGA焊接的温度曲线设置对于再流焊接非常重要。由于BGA组件尺寸较大且热导率较高,因此一般将其作为再流焊接温度曲线设置的重点监控对象。
BGA的焊接缺陷谱与封装构造、尺寸密切相关,根据常见不良可以大致总结为:
焊球间距小于1.0mm的BGA(也称为CSP)的主要焊接问题包括球窝、不润湿和桥接,这些问题在第4.3节中已经讨论过了。
对于焊球间隔大于1.0mm的PBGA、FBGA等封装形式,由于其动态变形特点,会出现不润湿开焊、不润湿开裂、缩锡断裂等独有且概率较小的焊接不良情况。这些焊接不良通常难以通过常规检测发现,易流入市场,存在较大的可靠性风险。
(3) BGA尺寸超过25mm x 25mm,由于尺寸较大,容易导致焊点应力断裂、坑裂等故障。